無線充電技術已存在一段時間,但近年來隨著感應無線充電技術的普及,其應用也越來越廣泛。然而,若要讓無線充電真正無所不在,並提供更好的終端使用者便利性(例如提高放置的自由度),無線充電解決方案需要進一步發展,而且隨著時間推移,可能會應用磁共振技術。以後者而言,它需要高傳輸頻率(數個MHz),並且將對發射器和接收器裝置內的標準矽功率技術帶來重大挑戰。
本文將介紹在無線充電的E類射頻(RF)功率放大器中使用氮化鎵(GaN)功率裝置的優勢,並強調GaN高電子遷移率電晶體(HEMT)裝置在此類功率放大器拓撲結構中優於金屬氧化物半導體場效電晶體(MOSFET)的優勢(除了D類之外),其拓撲結構是根據AirFuel聯盟的基準規格並針對無線電力傳輸用途而提出的。
無線充電逐次演進 新標準衍生新設計
目前大多數無線充電系統皆以電感(Qi)標準為基礎,透過頻率在100至300kHz範圍內的電感耦合進行運作。雖然這是較廣為採用的方法,但它只能為單一裝置充電,而且放置裝置時必須符合特定方向且非常靠近充電器。替代的拓撲已獲得越來越多的關注(例如E類),以透過諧振耦合實現更自由的無線電力傳輸設計。必須注意的是,它們並非新的拓撲結構,而且已成功用於射頻應用,其中的專業用語「放大器」已廣泛用於描述這些拓撲結構。利用這些拓撲結構,可在1至10MHz的運作頻率範圍內實現高效率。如圖1所示,這些功率放大器用於無線充電系統的發射器部分。
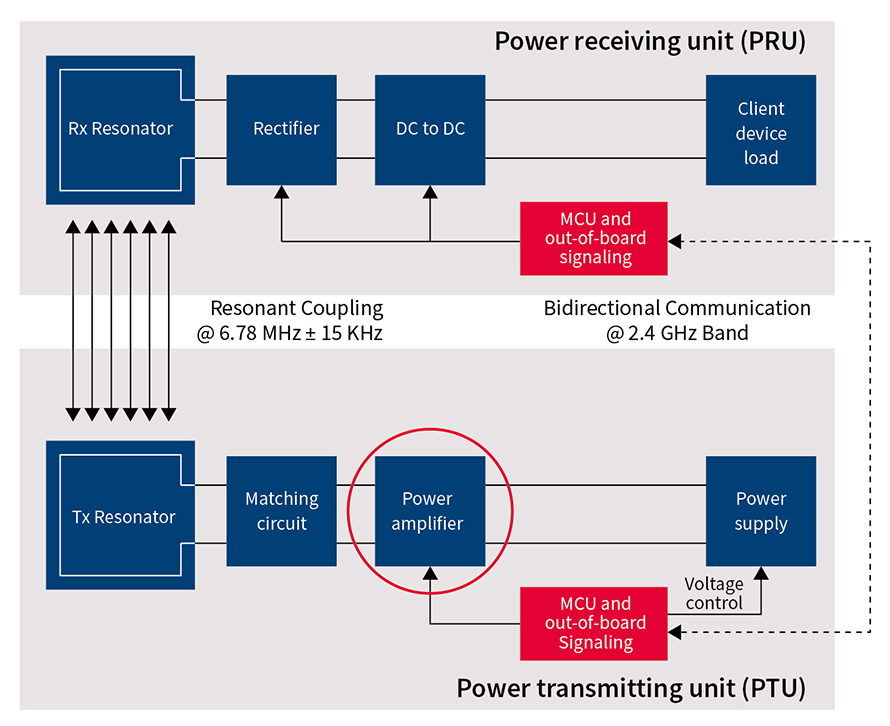 圖1 無線電力傳輸系統區塊
圖1 無線電力傳輸系統區塊
在以AirFuel聯盟提出的6.78MHz為基礎的諧振無線充電中,藉由使用諧振電感耦合,其高Q因數諧振器可利用周邊區域中明顯較弱的磁場,在更遠的距離範圍內傳輸電力。因此,這種諧振技術可實現「隨放即充」(Drop and Go)的近場充電體驗,並提供優於電感解決方案的使用者體驗和效益。
法拉第定律指出,當線圈包圍的磁通量變化時,線圈會產生電位。在無線電力傳輸中,射頻功率放大器藉由驅動功率傳輸單元(PTU,由諧振電路中的線圈組成),可產生變化的磁通量,並調諧為相同的頻率,同時在電力接收單元(PRU)中也可以看到電路中的線圈,它與磁場相交以誘導出電壓。此電壓取決於通量變化率和圈數。來自接收器線圈的輸出會進行整流,並轉換為所需的電位,以便為可攜式裝置充電。耦合取決於兩個線圈之間的間隔,以耦合係數k定義。小於0.5的k表示用於磁共振耦合的鬆散耦合系統。圖1顯示PTU和PRU的系統區塊,其中具有藍牙(Bluetooth)通訊的微控制器(MCU)用於請求和調節充電裝置所需的電力傳輸量。
目前在射頻系統中已證明了相對新穎的GaN技術的優點。現在,隨著GaN品質因數(FOM)的顯著改善,逐漸引起許多電源應用的關注。
圖2顯示GaN技術的改良與不同供應商提供的先進矽解決方案的比較。對數尺度有助於理解GaN技術所提供的巨幅躍升,它幾乎是所有FOM的一個數量級。
 圖2 GaN(各組最左柱)和矽技術(三家不同供應商)的FOM比較
圖2 GaN(各組最左柱)和矽技術(三家不同供應商)的FOM比較
善用獨特常關概念 e-mode GaN HEMT搶市
世界人口的不斷增加以及社會發展的加速,導致對電力的需求不斷升高,日益緊迫的環境壓力迫使人類以更少的能源完成更多事情。多年來,工程師持續尋求利用現有矽基半導體改善電路設計的方法,並不斷從設計中榨取更多效率。雖然這顯然帶來一些好處,但這方面的進展幅度很小,工程師正在尋求其他提高效率的機會。自固態電子產品問世以來,矽(Si)一直是功率裝置的首選材料,而新一代的寬能隙材料包括碳化矽(SiC)和氮化鎵(GaN)已進入市場,並為電源設計師帶來重要的機會。這些技術是實現能源效益世界的下一個重要步驟的關鍵,它可提供更高的電源效率、更小的尺寸、更輕的重量,以及更低的成本,或者囊括上述所有優點。
相較於矽,英飛凌(Infineon) CoolGaN增強型(e-mode)HEMT的崩潰場高出10倍,電子移動率為2倍。輸出電荷和閘極電荷皆比矽低10倍,逆復原電荷幾乎為零,這對於高頻操作極為重要。GaN是非常適合硬切換和諧振拓撲的技術,而且將會提供新的電流調變方法。此GaN解決方案以市場上最強大且高效能的概念為基礎:可提供快速開關速度的e-mode概念。CoolGaN產品專注於高效能和穩定性,並為許多應用(例如伺服器、電信、無線充電、變壓器和充電器,以及音訊)中的各種系統帶來重要的價值。
由於二維電子氣(2DEG)通道直接存在於GaN/AlGaN異質接面中,GaN裝置本質上是常開裝置。然而,電力電子產業強烈希望的是常關裝置。有兩種方法可以實現此期望:包括所謂的Cascode方法,或實現真正的單片增強模式裝置。廠商專注於其CoolGaN 400伏特(V)和600伏特裝置的e-mode GaN概念,它適用於所有消費性和工業應用。
降低與GaN相關的切換損耗,可提供更小巧輕量的設計。一方面,SMD封裝的裝置允許緊湊和模組化的設計,如此一來,還能使用更小的散熱器和更少的元件。第三,在某些應用中(如果需要)轉向更高的切換頻率可縮小被動元件的尺寸。在系統層級,以GaN為基礎的電源供應器具有更高的功率密度,因此可在相同體積內安裝更高的運算能力。
為了支援準確的使用壽命預測,廠商開發了一個高度結構化且準確的驗證計畫,它建立在四個關鍵領域上,包括預期的設定概況、應用的品質要求、產品開發過程中收集的可靠性數據,以及劣化模型。在CoolGaN的品質管理過程中,不僅會測試裝置,也會測試其在應用中的行為。CoolGaN的效能超越市場上的其他GaN產品。它提供超過15年的預估壽命,故障率低於1FIT率。
善用自身材料優勢 GaN跨足E類功率放大器
單端E類射頻功率放大器拓撲具備一個射頻電感器L1,它提供近似直流電流以切換FET Q1、諧振電路及負載,如圖3所示。Q1的切換頻率為6.78MHz,工作週期固定為50%。當電路調諧到相同頻率時,汲極處會出現半正弦電壓,其峰值為直流(DC)輸入電壓VIN的3.56倍,並在下一個切換週期開始之前降到零,因此會以零電壓切換(ZVS)運作。為了實現這一點,負載阻抗必須具有純電阻性。阻抗匹配電路配置於功率放大器和發射諧振器之間,用於抵消所有電抗元件。
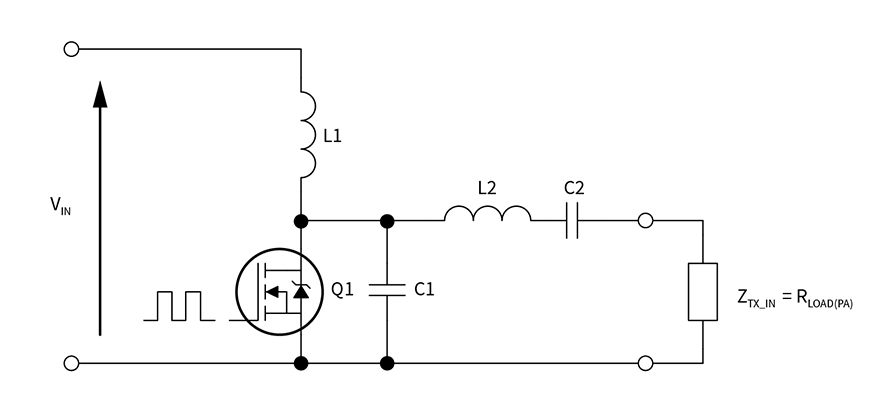 圖3 單端E類放大器主電路元件
圖3 單端E類放大器主電路元件
L2、C1和C2的值取決於兩個切換狀態的諧振頻率。當切換為關閉C1並與Q1的汲極至源極電容並聯時,有助於提高諧振頻率。當它處於較低的諧振頻率時,則僅取決於L2和C2。以ZVS運作而言,切換頻率必須位於較高和較低的諧振頻率之間,而且每個諧振頻率的半個週期的週期之和必須近似等於切換頻率的週期。
如果電路諧振高於切換頻率,則汲極電壓會振盪到更高的峰值,最高可達VIN的7倍,而且會在下一個切換週期開始之前降到零,因此在此期間會發生本體二極體導通。另一方面,如果電路諧振低於切換頻率,則在下一個切換週期開始時,汲極電壓將不會是零。如此將會產生硬切換,且在6.78MHz會有非常高的相關損耗。
為獲得高功率放大器效率,必須正確調諧電路,而且輸出電流不應過高,以避免集膚效應(Skin Effect)導致的導通和渦流損耗所造成的L2功率損耗,這在6.78MHz時非常重要。因此應設計PRU和阻抗匹配電路,為功率放大器負載開發高ZTX_IN。
GaN技術也為基於E類的功率放大器設計提供獨特的優勢。額定功率高達16瓦(W)的E類功率放大器已使用BSC12DN20NS3 200伏特、125毫歐姆(mΩ) OptiMOS 3開關進行測試。為了評估功率放大器的效能和效率,使用了電阻負載,並以25歐姆(Ω)、15歐姆和5歐姆進行測量。在各個情況下測量到的效率為91~92%。25歐姆的運作波形如圖4所示。
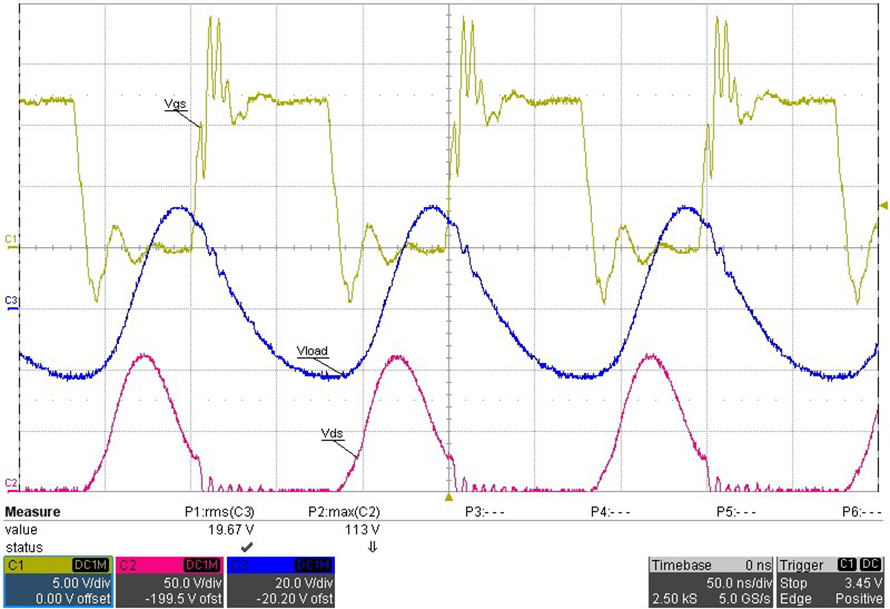 圖4 使用矽MOSFET的單端E類放大器運作波形
圖4 使用矽MOSFET的單端E類放大器運作波形
在圖4中,最下方的波形曲線顯示汲極電壓波形。可以觀察到該形狀並非純半正弦波,在較低電壓時顯示減少的斜率,如此可避免在下個切換週期之前持續下降到零而導致硬切換。此效應是由MOSFET COSS對電路的上諧振頻率的影響所引起的。矽MOSFET COSS在較低電壓下顯著增加時會產生此種失真。雖然電路能以可接受的效率工作,而且由少量硬切換引起的切換損耗並不高,但這仍然造成問題。此電路必須重新調諧,以產生更高的峰值電壓,如此可降低最大功率容量和輸出阻抗範圍,讓功率放大器在不達到MOSFET突崩額定值BVDSS的情況下運作。
具有相同BVDSS和RDS(on)額定值的GaN HEMT也在相同的電路中進行測試,結果如圖5所示。圖6比較兩個功率切換類型的COSS特性並以對數尺度繪製,顯示出雖然半個BVDSS在VDS的規格表數值非常相似,但GaN裝置的增加程度遠小於MOSFET。
 圖5 使用GaN HEMT的單端E類放大器運作波形
圖5 使用GaN HEMT的單端E類放大器運作波形
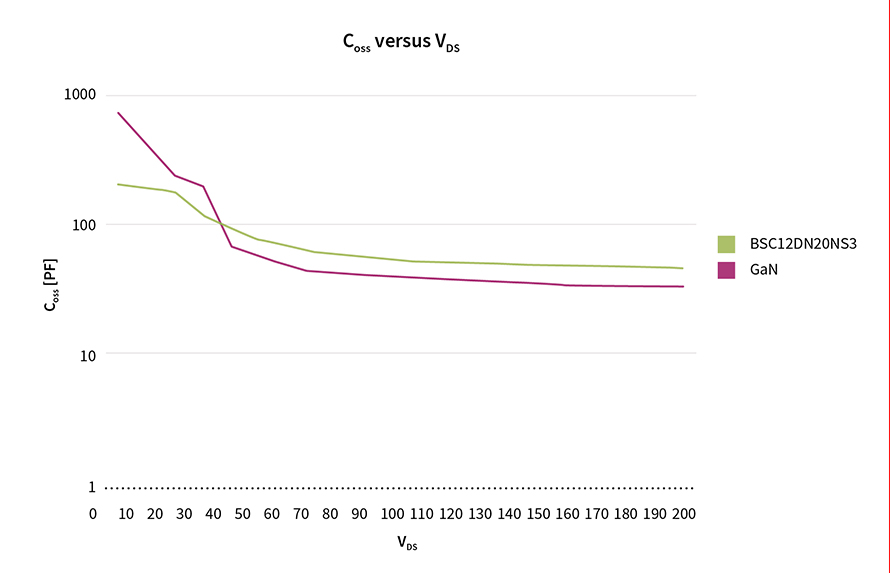 圖6 矽MOSFET和GaN HEMT的COSS vs VDS比較
圖6 矽MOSFET和GaN HEMT的COSS vs VDS比較
可以看到基於GaN的汲極波形比MOSFET範例中的正弦曲線來得更高。沒有硬切換且峰值電壓等於VIN的3.56倍,這表示電路以理論最佳狀態運作。如此將可在更寬廣的範圍內運作。此外,在實際運作中,電路更容易調諧,而且較不容易因為公差和溫度而產生漂移。
瞄準無線電力傳輸 GaN爭搶一席之地
GaN裝置在無線電力傳輸中的優勢,從以下兩個面向來加以說明。
降低閘極電荷損耗
GaN裝置通常以5伏特閘極驅動電壓驅動,而標準矽MOSFET通常以10伏特左右的電壓驅動。GaN裝置的閘極電荷(QG)約為MOSFET或類似RDS(on)和VBRR的五分之一,這導致閘極驅動電流顯著降低,並大幅降低閘極驅動器IC的損耗。為了讓閘極電荷損耗達到理想狀況的最小化,不僅要選擇低QG,還要使用具有低閘極臨界值電壓的裝置技術,讓設計者能使用較低的驅動電壓,藉此降低與驅動電路相關的整體損耗。而閘極電荷損耗可用公式1計算:
 公式1
公式1
以ZVS轉移為假設,當電壓為Vdr且沒有QGD的情況下,閘極電荷是QG_SYNC,fSW為切換頻率,Vdr為驅動電壓。
本體二極體損耗
雖然GaN HEMT裝置沒有像MOSFET這種實際的本體二極體,它們確實表現出類似二極體的行為。本體二極體正向電壓是系統損耗的另一個重要來源,實際上在GaN裝置中更高。在E類拓撲中,可透過正確調諧電路以避免二極體導通(公式2)。
 公式2
公式2
在評估本體二極體損耗時,重點是計算正確的VSD值,該值會隨著電流和溫度而變化。
確切掌握GaN特性 融入無線充電設計
上一段內容已解釋為何GaN技術可提供許多提高系統整體效率的機會。然而,這並非平白得來的好處,GaN技術在系統設計過程中需要考慮一些屬性。應考量的設計標準,包括以下幾項:
驅動電壓精度
根據規格表中指出,MOSFET的VGS絕對最大額定值通常為+/-20伏特,這為設計人員提供一些自由度,能以相對簡單和便宜的方式保留驅動級穩壓器。
但對於GaN而言,情況並非如此。絕對最大額定值限制在大約5至6伏特,這主要是因為閘極結構的二極體本質。如果在最壞的情況下,閘極源電壓在運作期間超過此極限,將可能對裝置造成嚴重損壞,或最多是縮短其使用壽命。
由於上述原因,用於產生驅動電壓的穩壓器設計必須非常謹慎,因為適用於矽的解決方案可能不適用於GaN。
閘極電流
行為與矽基產品不同,其中的閘極是透過閘極氧化層隔離器控制的。GaN裝置的閘極連接採用蕭特基阻障的形式,因此其中的漏電流不在奈安培(nA)而是在毫安培(mA)的範圍內。選擇閘極驅動電壓和驅動電路組件時應特別謹慎。
裝置面積
如前段內容所述,GaN技術可提供更高的功率密度,這是由低RDS(on)×面積的數據所導致的。這是因為二維電子氣(2DEG)具有高傳導性,可為希望提高應用之功率密度的設計者提供極具吸引力的特性,但也會帶來一些挑戰。面積較小的事實,意味著將有較小的接觸面積來擷取裝置內部消耗的功率。在布局階段,裝置和印刷電路板(PCB)之間的電源連接設計將更具挑戰性,並且裝置的熱阻可能會有所損失。由於最重要的熱阻是與環境的接面,這主要取決於印刷電路板的特性,較小的GaN裝置封裝尺寸不應產生過多額外的熱阻。在任何情況下,設計印刷電路板期間都應特別小心,使上述熱阻達到最小化,因為GaN較小的面積可能會部分抵消掉該技術的優點。
GaN HEMT嶄露頭角 搶進無線充電領域
在無線充電設計中,能源效率、更短充電時間及更高功率密度一直是工程師關心的議題。整體無線充電市場正快速成長,需要更高的半導體效能,以滿足甚至超越終端客戶的需求。本文所執行的應用研究和測量,證明了GaN HEMT在採用E類射頻功率放大器的無線充電設計中所提供的顯著價值。GaN HEMT能夠在此應用領域中,同時超越效率和密度的極限。
(本文作者任職於英飛凌)